半导体封装方案
半导体封装工艺,从1基板搭载1芯片的单芯片FC-BGA转变为复数的半导体芯片实装在中间层的2.5D
SIP(System in Package)。 BGA-Ball(φ150~760μm)、FC-Ball(φ60~90μm)
的技术研究确立、半导体芯片实装在Micro-Ball成为今后的课题。
弊司与晶圆植球机厂家Athlete FA共同开发了搭载φ30μmMicro-Ball的技术。
弊司与晶圆植球机厂家Athlete FA共同开发了搭载φ30μmMicro-Ball的技术。
半导体封装(SIP)的模式图

中介层实装复数的芯片 System in Package
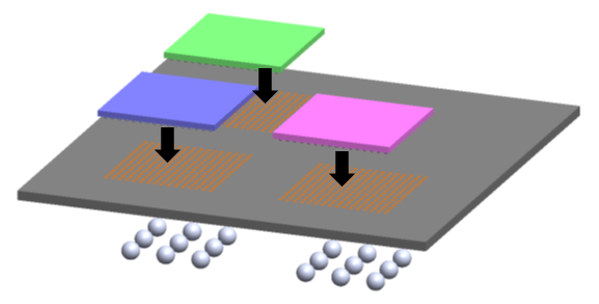
凹版印刷可达成的细微印刷技术还可以应用在搭载锡球时所需要的高精度助焊剂印刷。
使用凹版印刷可以突破一般钢板的印刷界线,达到φ30μm(间距60μm)的印刷。
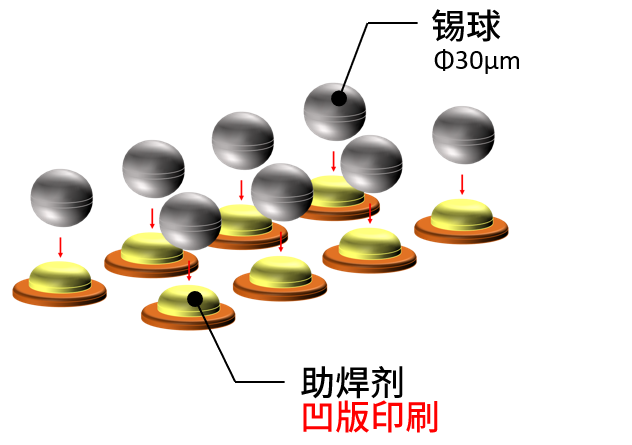
电极


印刷助焊剂


搭载锡球

高精度的印刷位置为凹版印刷的一大特征。
因其不像丝网印刷会因为网版歪斜影响,所以在印刷原理上十分有利。
可以在电极上正确地印刷助焊锡的位置。
丝网印刷
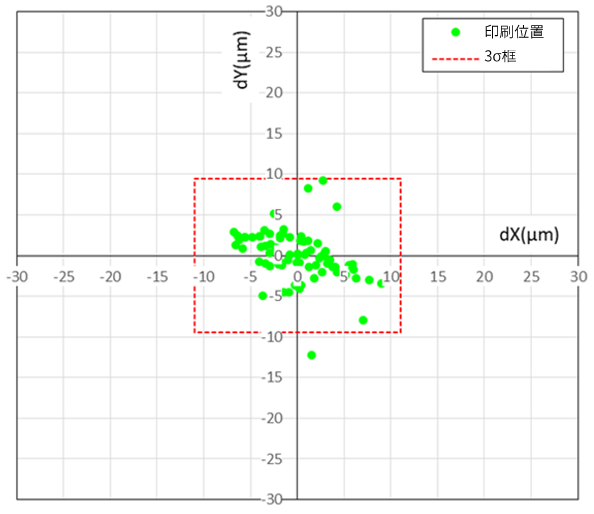

凹版印刷
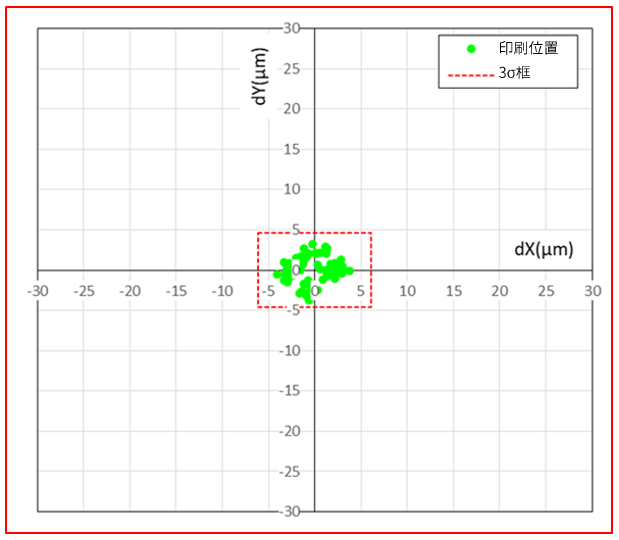

PEPIO-F12SC

BM-1400W
询问:资料索取请按此
询问
Copyright© 2017-2025 SERIA CORPORATION
