Semiconductor Packaging Solutions
Semiconductor packages have evolved from single-chip FC-BGA, which mounts
one chip on one substrate, to 2.5D SIP (System in Package), which mounts
multiple semiconductor chips on an interposer. The technology for BGA-Ball
(φ150-760μm) and FC-Ball (φ60-90μm) has been established for some time.
The challenge now is to realize Micro-Balls for mounting semiconductor
chips.
In collaboration with Athlete FA Corporation, a ball mounting machine manufacturer, we have established Micro-Ball mounting technology with a diameter of φ30μm.
In collaboration with Athlete FA Corporation, a ball mounting machine manufacturer, we have established Micro-Ball mounting technology with a diameter of φ30μm.
Schematic Diagram of Semiconductor Package (SIP)
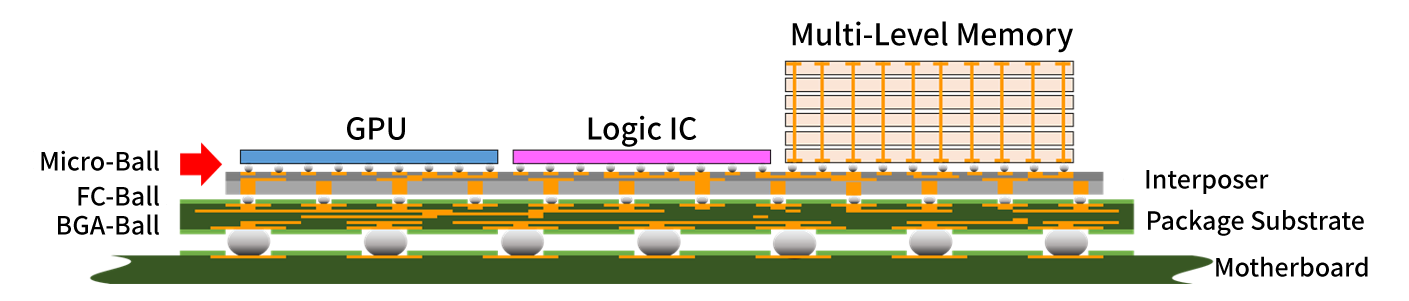
System in Package: Mounting multiple chips on an interposer
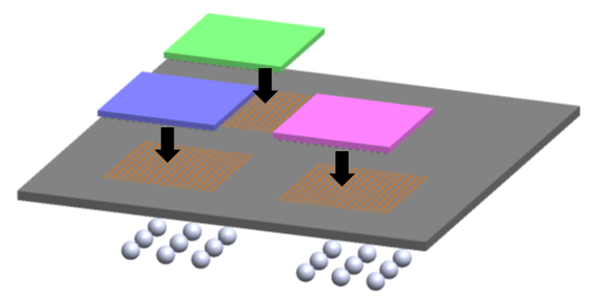
By applying fine printing technology using gravure offset, we print the
flux paste required for mounting solder balls with a high degree of
precision. Gravure offset printing makes it possible to print at a
diameter of 30 μm (pitch 60 μm), exceeding the limits of conventional
screen printing using metal masks.
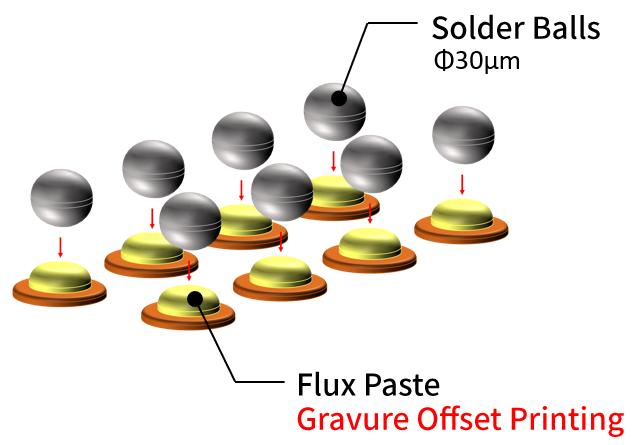
Electrodes


Print Flux Paste


Mounting Solder Balls

One of the major features of gravure offset printing is its excellent
printing position accuracy. In principle, it is advantageous because it
does not distort the screen mask as in screen printing. Flux paste can be
printed accurately on the electrodes.
Screen Printing
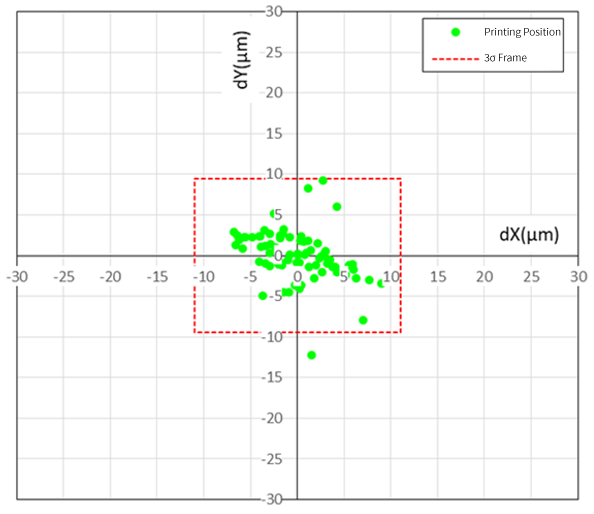

Gravure Offset Printing
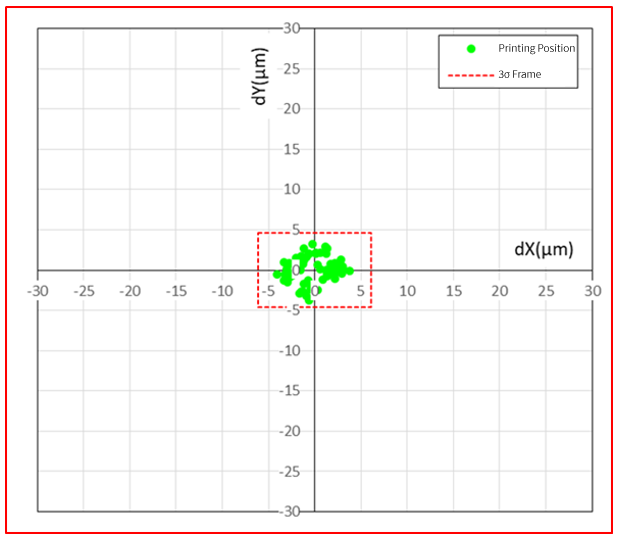

PEPIO-F12SC

BM-1400W
For consultations and requests for materials, please click here
Inquiry
Copyright© 2017-2025 SERIA CORPORATION
